|
 Molex
開發了新的表面焊接技術(SMT)方法,與傳統的 SMT 焊接方法相較具有更高的的疲勞強度,並降低應用成本。Solder Charge
技術已經迅速被主要的 OEM 和合約製造商(CMs)採用,與典型的錫球焊接(BGA)方法相較,可以增進產量和提高可靠性。 Molex
開發了新的表面焊接技術(SMT)方法,與傳統的 SMT 焊接方法相較具有更高的的疲勞強度,並降低應用成本。Solder Charge
技術已經迅速被主要的 OEM 和合約製造商(CMs)採用,與典型的錫球焊接(BGA)方法相較,可以增進產量和提高可靠性。
新一代 Molex Solder Charge 採用傾斜的焊接片,提供在剪切強度和拉力上更耐用的連接方法,使之優於 BGA
焊接方式。在連接器的裝配過程中,與將焊珠熔化在金屬片上相較,衝壓的 Solder Charge 成本更低並且更精確。
將 Solder Charge 技術融入設計過程,可以提供勝於標準 BGA
連接的多種優點,包括:其機械製程的設計允許焊後品質的目視檢查,減少對 Dage x 射線篩選的依賴;將與PCB板的保持強度大約提高至典型
BGA 的三倍,降低了焊接接頭上的應力,提高了合規性並降低應用成本。
新技術可降低製程時間,減少返工及二次處理,促進量的提高,衝壓模具的精確成形增進,Solder
Charge成型和焊接製程的精密度;靈活的焊料品質補償電路板變形;適用於錫鉛或無鉛設計,均不會提高成本。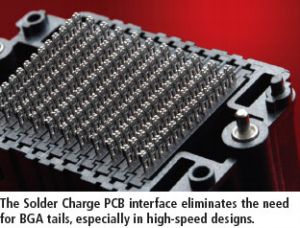
Molex Solder
Charge焊接技術適用高速電路,允許傳輸線直接抵達PCB,大幅地減少對設計干擾,並維持系統的電氣特性。Solder
Charge便捷地調節PCB平面度的不一致性,促進統一的焊接製程,並減少由於其它設計變化而導致的焊接面上的問題。因而可以採用更低成本的電路板設
計,而無需犧牲產品的完整性。
在Molex的HDMezz和SEARAY連接器系統,以及目前正開發的新的連接器設計中提供的Solder
Charge技術,可以運用於目前使用BGA焊接方法的大量產品中。 |

